2018年上半年,微電子學(xué)院、寬帶隙半導(dǎo)體技術(shù)重點(diǎn)實(shí)驗(yàn)室郝躍院士科研團(tuán)隊(duì)在高性能微電子器件研究領(lǐng)域取得了一系列重大進(jìn)展,在IEEE旗下IEEE Electron Device Letters、IEEE Transactions on Electron Devices等重要期刊上連續(xù)發(fā)表28篇高質(zhì)量的學(xué)術(shù)論文。
郝躍院士團(tuán)隊(duì)一直致力于微電子前沿領(lǐng)域?qū)捊麕?超寬禁帶半導(dǎo)體材料與器件、后摩爾時(shí)代新器件的基礎(chǔ)研究與技術(shù)研發(fā),不斷取得突破性進(jìn)展。今年上半年在高效率和高線性的氮化物半導(dǎo)體高電子遷移率晶體管(HEMT)、超寬禁帶半導(dǎo)體材料和器件、非硅溝道場(chǎng)效應(yīng)晶體管、鐵電柵控的負(fù)電容場(chǎng)效應(yīng)晶體管等新型器件,以及鈣鈦礦材料和器件方面取得了多項(xiàng)重大進(jìn)展和標(biāo)志性成果。
|
期刊名稱
|
發(fā)表論文篇數(shù) |
| IEEE Electron Device Letters | 11 |
| IEEE Transactions on Electron Devices | 6 |
| IEEE Journal of the Electron Devices Society | 2 |
| IEEE Photonics Journal | 5 |
| IEEE Transactions on Device and Materials Reliability | 1 |
| IEEE Journal of Lightwave Technology | 1 |
| IEEE Photonics Technology Letters | 1 |
| IEEE Journal of Quantum Electronics | 1 |
郝躍院士團(tuán)隊(duì)2018年上半年在IEEE期刊發(fā)表學(xué)術(shù)論文統(tǒng)計(jì)

郝躍院士課題組團(tuán)隊(duì)合影
寬禁帶半導(dǎo)體器件性能實(shí)現(xiàn)不斷突破
以氮化物為代表的寬禁帶半導(dǎo)體是繼硅、砷化鎵之后最重要的微電子技術(shù)新領(lǐng)域。氮化物半導(dǎo)體在無(wú)線通信微波器件、電能轉(zhuǎn)換功率開(kāi)關(guān)器件、新型LED照明與顯示器件等諸多領(lǐng)域有著重要應(yīng)用。郝躍院士團(tuán)隊(duì)從1997開(kāi)始從事氮化物半導(dǎo)體材料和器件的研究,在高質(zhì)量材料生長(zhǎng)及高性能器件研制方面不斷取得突破進(jìn)展,顯著提升了我國(guó)第三代半導(dǎo)體關(guān)鍵材料和器件的水平,對(duì)推動(dòng)電子產(chǎn)業(yè)轉(zhuǎn)型升級(jí),培育新的經(jīng)濟(jì)增長(zhǎng)點(diǎn)具有重要意義。
2018年上半年,在高性能氮化物HEMT器件領(lǐng)域,肖明博士報(bào)道了基于緩變緩沖層的AlGaN溝道HEMT器件,實(shí)現(xiàn)了國(guó)際上AlGaN溝道器件最高水平的飽和輸出電流。盧陽(yáng)博士通過(guò)團(tuán)隊(duì)提出的圖形化歐姆接觸技術(shù),實(shí)現(xiàn)了極低的歐姆接觸電阻0.12Ω·mm,與現(xiàn)有技術(shù)相比,歐姆接觸電阻減小70%。肖明博士通過(guò)低功率表面氧化處理技術(shù)實(shí)現(xiàn)了開(kāi)關(guān)比達(dá)4×106,泄漏電流低至2.6×10-7A/mm、輸出電流達(dá)1.36A/mm的高性能增強(qiáng)型AlN/GaNHEMT器件。侯斌博士通過(guò)電荷俘獲技術(shù)實(shí)現(xiàn)了0.9A/mm、閾值電壓為2.6V的Flash-like的高性能增強(qiáng)型Al2O3/ AlGaN/GaN MIS-HEMTs器件。張力碩士在國(guó)際上首次報(bào)道了新型p-GaN型橋增強(qiáng)型AlGaN溝道柵注入晶體管,通過(guò)優(yōu)化源接觸的p-GaN橋結(jié)構(gòu),可實(shí)現(xiàn)4~7V范圍內(nèi)的可調(diào)節(jié)閾值電壓。相關(guān)結(jié)果均發(fā)表在IEEE Electron Device Letters上。
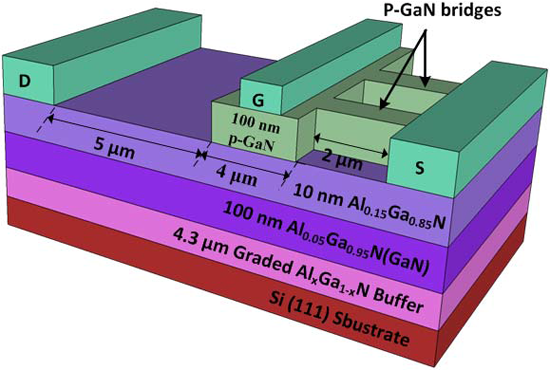
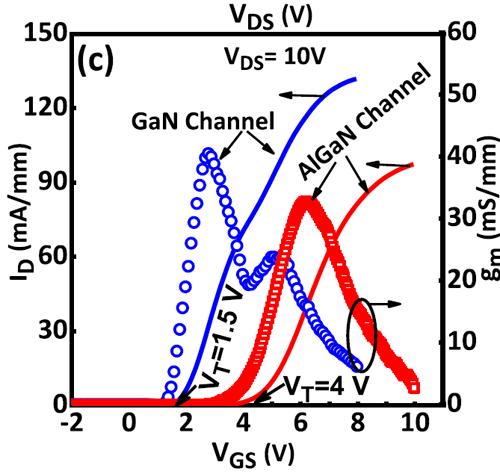
張力碩士報(bào)道的新型AlGaN溝道增強(qiáng)型器件相關(guān)結(jié)果
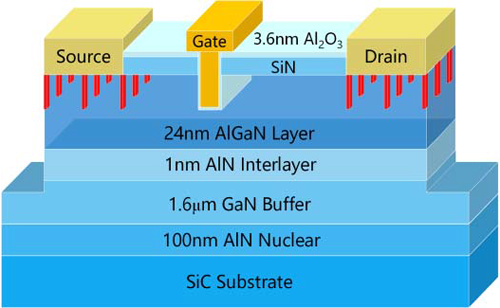
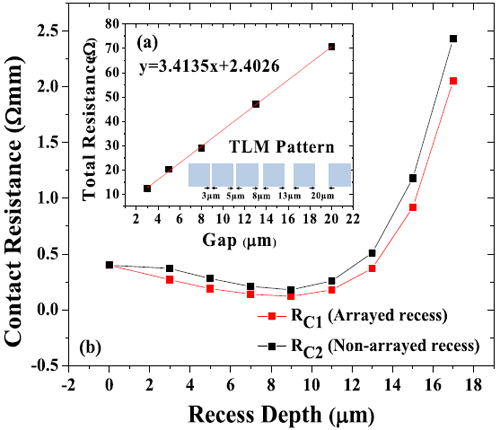
盧陽(yáng)博士報(bào)道的新型低歐姆接觸電阻技術(shù)相關(guān)結(jié)果
后摩爾時(shí)代新器件技術(shù)研究進(jìn)展
“后摩爾時(shí)代新器件技術(shù)”是郝躍院士團(tuán)隊(duì)近年來(lái)力推的新型研究方向。隨著CMOS技術(shù)節(jié)點(diǎn)按比例縮小(scaling)逐漸走向終結(jié),采用新型器件結(jié)構(gòu)成為延續(xù)摩爾定律的必然選擇。因此,后摩爾時(shí)代新器件將影響和決定未來(lái)微電子器件技術(shù)發(fā)展和集成電路產(chǎn)業(yè)格局。
隨著集成電路技術(shù)發(fā)展到納米尺度,現(xiàn)有的半導(dǎo)體器件會(huì)迎來(lái)短溝道效應(yīng)、高泄漏電流和60mV/dec的亞閾值擺幅的限制等問(wèn)題。隧穿場(chǎng)效應(yīng)晶體管(TFET)和基于鐵電材料高遷移率鍺基溝道負(fù)電容MOSFET器件等新型器件技術(shù)有望能夠解決這些問(wèn)題。
周久人博士連續(xù)在IEEE Electron Device Letters上發(fā)表4篇學(xué)術(shù)論文,系統(tǒng)地驗(yàn)證了鐵電MOSFET器件中的負(fù)電容效應(yīng)以及負(fù)電容對(duì)器件電流和亞閾值擺幅的提升作用,詳細(xì)研究了介質(zhì)層特性對(duì)器件特性的影響。段小玲博士提出了一種高性能柵調(diào)制InGaN無(wú)摻雜TFET(DL-TFET)器件,并且從雙極特性、關(guān)態(tài)電流、開(kāi)關(guān)比、亞閾值擺幅等方面對(duì)器件特性進(jìn)行了系統(tǒng)地理論分析。此外,郝躍院士團(tuán)隊(duì)還在光電探測(cè)器、新型二維材料及器件等領(lǐng)域相繼發(fā)表多篇高水平學(xué)術(shù)論文。

周久人博士報(bào)道的負(fù)電容晶體管制作工藝及結(jié)構(gòu)
按照郝躍院士確定的“人無(wú)我有,人有我優(yōu)”(First and/or Best)的團(tuán)隊(duì)奮斗目標(biāo),面向國(guó)際微電子學(xué)術(shù)前沿和微電子核心技術(shù)主戰(zhàn)場(chǎng),團(tuán)隊(duì)按照“大項(xiàng)目、大團(tuán)隊(duì)、大平臺(tái)、大成果”的發(fā)展路線,經(jīng)過(guò)20多年的勵(lì)精圖治,使得我國(guó)在多個(gè)微電子新器件領(lǐng)域在國(guó)際上有了重要地位,也使我校在國(guó)際微電子領(lǐng)域具有重要影響。

 粵公網(wǎng)安備 44030902003195號(hào)
粵公網(wǎng)安備 44030902003195號(hào)