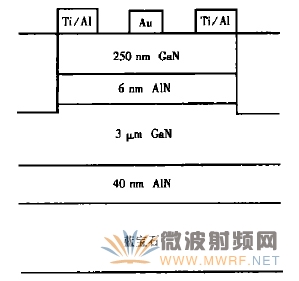
圖2、GaN MESFETs 剖面結(jié)構(gòu)圖
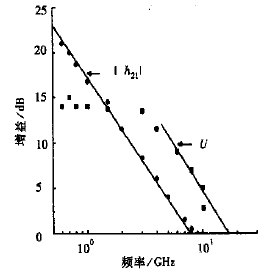
圖3、0.7m 擅長器件的電流增益|h21| 和單邊增益U
從目前來看,相對于其他GaN 基器件,GaN MESFETs 生長和制造工藝相對較為簡單。但對于MESFET 而言,獲得較高的跨導(dǎo)需要一個高摻雜的溝道,而肖特基結(jié)的形成通常要求溝道輕摻雜。折中的結(jié)果最終導(dǎo)致溝道較厚、溝道雜質(zhì)濃度較低,因此與GaAs MESFETs 所獲得的跨導(dǎo)值(一般為200mS/ mm)相比,GaNMESFETs 的跨導(dǎo)值(最大為23mS/ mm)相對較低。此外,體GaN 溝道中的低電子遷移率往往導(dǎo)致高的級聯(lián)電阻,使得GaN MESFETs 的射頻性能受到限制[6],不能完全發(fā)揮它的優(yōu)勢。
2.2、HFETs
自1992 年Khan 等人首次對Alx Ga1- xN/ GaN 異質(zhì)結(jié)界面的電子遷移率進(jìn)行了實驗研究,指出AlxGa1- xN/GaN 異質(zhì)結(jié)處的電子遷移率可以達(dá)到極高的值之后,眾多的研究[7,8] 先后都表明Alx Ga1- xN/GaN 結(jié)構(gòu)界面處可以產(chǎn)生二維電子氣(2DEG),具有很高的電子遷移率,電子密度也相應(yīng)比較高。此外,AlxGa1- xN/ GaN 界面上的肖特基勢壘也比GaN 形成的肖特基勢壘要高,這都為有效地產(chǎn)生微波功率提供了重要的材料基礎(chǔ)。
目前,GaN HFETs,MODFETs 以及MISFETs 等新型微波功率器件都是以Alx Ga1- x N/ GaN 異質(zhì)材料為基礎(chǔ),利用異質(zhì)界面上形成的2DEG[8] 的優(yōu)良傳輸特性來滿足微波大功率要求的。圖4 即是用于HFET 的AlGaN/ GaN 異質(zhì)結(jié)構(gòu),包括一個厚的GaN 層,一個輕摻雜的GaN 層以及淀積在輕摻雜GaN 層上的AlGaN 層。相對于直接利用GaN 制造的器件來說,在圖4 結(jié)構(gòu)基礎(chǔ)上制造的器件具有更大的潛力,這主要是Alx Ga1- xN/ GaN 異質(zhì)結(jié)界面上可形成二維電子氣,使得遷移率得到進(jìn)一步增強(qiáng)。同時還可以采用在介質(zhì)層上插入一個未摻雜的AlGaN 空間層和調(diào)制摻雜的方法來提高2DEG 結(jié)構(gòu)中的傳輸特性,使得GaN 基HFET,MODFET的器件性能明顯優(yōu)于GaAs 基結(jié)構(gòu)。
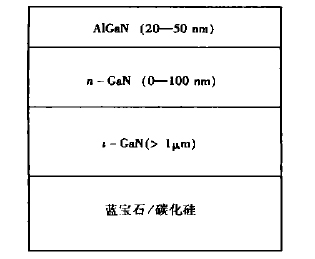
圖4、AlGaN/ GaN 結(jié)構(gòu)圖
2.2.1、AlGaN/ GaN HFETs
AlGaN/ GaN HFETs 異質(zhì)結(jié)場效應(yīng)晶體管,是直接以AlGaN/ GaN 異質(zhì)結(jié)材料為基礎(chǔ)而制造的GaN 基器件。眾多的研究[6~ 11] 表明了其在微波大功率應(yīng)用方面具有巨大優(yōu)勢:1994 年,Khan 等人[9] 在大約1,01X105 Pa的壓力下以三乙基鋁、三乙基鎵和氨氣(NH3)作為氮源,在低壓MOCVD 反應(yīng)器中生長出了AlGaN/ GaN 異質(zhì)結(jié),并采用Ti/ Au 和Ti/W 作為源-漏和柵接觸,制造出了AlGaN/GaN HFET,其結(jié)構(gòu)圖參見圖5。當(dāng)柵長為0.25 μm時,其截止頻率f T 和最大振蕩頻率f max 分別為11GHz和35GHz,與GaN MESFET 相比,性能有了很大的提高。1998 年,Thibeault 等人制造出了截止頻率f T 為4GHz,輸出功率為1.4W的GaN HFET;Siram等人則制造出了f T 為10 GHz,輸出功率為0.85W的GaN HFET;Sullivom 等人[10] 制造出的HFET 的f T 為10 GHz,輸出功率為3.3W。需要說明的是,這些GaN HFET 都是在藍(lán)寶石襯底上制造的。一方面,由于藍(lán)寶石的熱導(dǎo)性比較差,容易導(dǎo)致高的結(jié)溫度并降低大功率晶體管的效率;另一方面,藍(lán)寶石與GaN 的晶格失配比較大,導(dǎo)致在加速生長冷卻后存在顯著的應(yīng)力。這兩種原因都使得難以在藍(lán)寶石襯底上生長出質(zhì)量較好的GaN 外延層。因此為了提高微波功率,必須尋找更為合適的材料作為襯底以突破這些限制。SiC 材料相對于藍(lán)寶石而言具有高的熱導(dǎo)率,并同GaN 具有較小的晶格失配,因此可以考慮用SiC 材料代替藍(lán)寶石作為襯底。1998 年,Shepperd 等人成功地在SiC 襯底上制成了AlGaN/ GaN HFETs,其截止頻率f T 為10GHz,功率密度為6.8W/mm,比藍(lán)寶石HFETs 性能更好。1999 年,Q.Chen 等人[6] 在n 型和p 型SiC 襯底上制成了AlGaN/ GaNHFETs,器件性能非常理想。對于n 型SiC 襯底的器件,他們使用4.5 μm的柵寬,采用He 離子注入的方式進(jìn)行隔離;對于p 型SiC 襯底的材料,他們使用100μm的柵寬,采用RIE 刻蝕和離子注入兩種方法進(jìn)行隔離。器件中歐姆接觸采用Ti/Al 金屬結(jié)構(gòu),柵肖特基接觸采用Ni/ Au 雙層結(jié)構(gòu)。最終獲得的功率密度為6.4W/ mm,在8 V偏壓和0.4A/ mm電流密度下的截止頻率f T 和最大振蕩頻率f max 分別為53 GHz和58 GHz。

 粵公網(wǎng)安備 44030902003195號
粵公網(wǎng)安備 44030902003195號